有机物鉴别物质的方法 从没见过这么全的材料表面形貌测试分析,材料人必看!(2)
应用:
缺陷分析;颗粒分析;表面分析;小面积深度剖面;工艺控制;薄膜成分分析。
样品要求:
(1)样品最大规格尺寸为1×1×0.5cm,当样品尺寸过大需切割取样;
(2)由于AES测试深度太浅,无法对样品喷金后再测试,所以绝缘的样品不能测试,只能测试导电性较好的样品;
(3)AES元素分析范围Li-U,只能测试无机物质,不能测试有机物物质,检出限0.1%。
具体案例:
X射线光电子能谱/电子光谱化学分析仪(XPS/ESCA)
X射线光电子能谱(XPS),也称电子光谱化学分析仪(ESCA),用来鉴定样品表面的化学性质及组成的分析,其特点在光电子来自表面10nm以内,仅带出表面的化学信息,具有分析区域小、分析深度浅和不破坏样品。
工作原理:
使用X射线去辐射样品,使原子或分子的内层电子或价电子受激发射出来光电子,可以测量光电子的能量和数量,从而获得待测物组成。
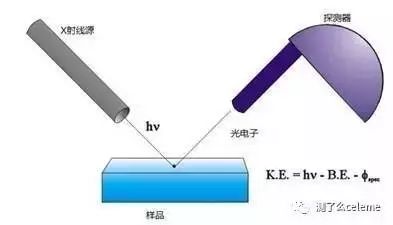
测试仪器:

X射线光电子能谱仪/XPS
应用:
(1)表面化学状态识别 ;
(2)除H和He外,所有元素的识别 ;
(3)定量分析,包括样品间化学状态的不同;
(4)适用于多种材料,包括绝缘样品(纸,塑料、玻璃) ;
(5)材料本体水平浓度的深度 ;
(6)氧化物厚度测量。
样品要求:
(1)样品最大规格尺寸为1×1×0.5cm,当样品尺寸过大需切割取样。
(2)取样的时候避免手和取样工具接触到需要测试的位置,取下样品后使用真空包装或其他能隔离外界环境的包装,避免外来污染影响分析结果。
(3)XPS测试的样品可喷薄金(不大于1nm),可以测试弱导电性的样品,但绝缘的样品不能测试。
(4)XPS元素分析范围Li-U,只能测试无机物质,不能测试有机物物质,检出限0.1%。
二次离子质谱(SIMS)
二次离子质谱分析技术(SIMS)是通过一束初级离子来溅射样品表面。有机物鉴别物质的方法二次离子在溅射过程中形成并被质谱仪提取分析。有机物鉴别物质的方法
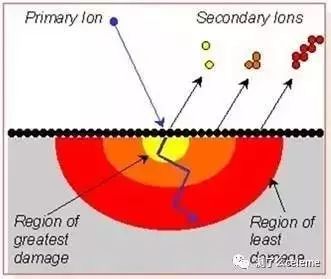
二次离子激发示意图
测试原理:
样品表面被高能聚焦的一次离子轰击时,一次离子注入被分析样品,把动能传递给固体原子,通过层叠碰撞,引起中性粒子和带正负电荷的二次离子发生溅射,根据溅射的二次离子的质量信号,对被轰击样品的表面和内部元素分布特征进行分析。
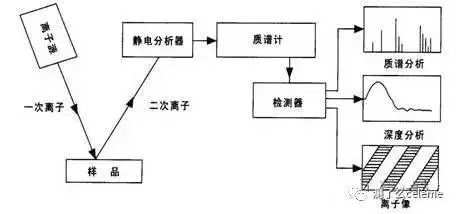
在高能一次离子作用下,通过一系列双体碰撞后,由样品内到达表面或接近表面的反弹晶格原子获得了具有逃逸固体所需的能量和方向时,就会发生溅射现象。

测试仪器:
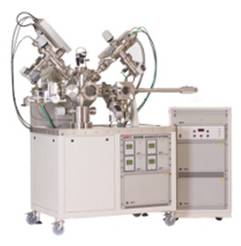
二次离子质谱(SIMS)
应用:
(1)鉴别在金属、玻璃、陶瓷、薄膜或粉末表面上的无机物层或有机物层;
(2)氧化物表层、腐蚀膜、沥滤层和扩散层沿深度的浓度分布;
(3)半导体材料中的微量掺杂剂(≤1000ppm)沿深度的浓度分布;
(4)在脆化金属合金、气相沉积薄膜、水合玻璃和矿物质中的氢浓度和氢沿深度的分布;

(5)定量分析固体中的痕量元素。
样品要求:
(1)晶态或非晶态固体,表面经修饰的固体、或具有沉积薄膜或镀层的基底,样品表面最好是平坦而光滑的,粉末样品必须将其压入软金属箔(如铜)中或压制成小块;
(2)样品尺寸可变,最大尺寸1cm×1cm×1cm。
参考标准:
ASTM E1078-2009表面分析中试样制备和安装程序的标准指南;
ASTM E1504-2011次级离子质谱(SIMS)测定中质谱数据报告的标准规范;
ASTM E1829-2009 先于表面分析的样品处置标准指南。
飞行时间二次离子质谱仪(TOF-SIMS)
TOF-SIMS具备高灵敏度,测量浓度可达到ppm数量级,高纵向分辨率,分析区域小等特点。测试可以得知样品表面和本体的元素组成和分布,能最好地实现对样品几乎无损的静态分析,在材料的成份、掺杂和杂质沾污等方面的分析中有重要地位。
#易烊千玺#要多带大名易烊千玺早安